― 薄膜の大面積化実現に大きく前進―
立命館大学総合科学技術研究機構の金子健太郎 教授/RARAフェローとPatentix株式会社(所在地:滋賀県草津市、代表取締役:衣斐豊祐)は、共同で、二酸化ゲルマニウム(GeO2)をPhantomSVD(ファントム局所的気相成長)法によって、4インチウエハ上に製膜することに世界で初めて成功しました。
Patentix株式会社は、立命館大学発ベンチャーであり、超ワイドバンドギャップ半導体(UWBG)材料「二酸化ゲルマニウム」を用いた半導体基板・パワーデバイスの研究開発を進めています。この成果は、二酸化ゲルマニウム薄膜の大面積化できる可能性を示す大きな成果となりました。
1.概要
ルチル構造二酸化ゲルマニウム(r-GeO2)は、炭化ケイ素(SiC)や窒化ガリウム(GaN)と比べてさらに大きなバンドギャップをもつため、r-GeO2によるトランジスタやダイオードは高耐圧、高出力、高効率(低損失)という優れたパワーデバイス特性を備える事が期待されています。r-GeO2パワーデバイスの開発は日本が世界をリードしており、Patentix株式会社では2022年12月会社設立以降、r-GeO2の研究開発を進めております。
また、Patentix株式会社では、独自に開発したPhantomSVD(ファントム局所的気相成長)法を用いて製膜しており、PhantomSVDは、安全安価な原料溶液を用いることができコストパフォーマンスに優れています。また、従来の霧(ミスト)状にした溶液を用いるCVD法とは異なる原理で結晶成長が可能であり、より高品質かつより安全・安心な薄膜合成が可能となります。
2.今回の成果及び今後の予定
立命館大学およびPatentix株式会社は、共同で、次世代半導体材料として注目される「二酸化ゲルマニウム(GeO2)」をPhantom SVD(ファントム局所的気相成長)法によって、4インチウエハ・Si(100)上に製膜することに世界で初めて成功しました。この成果は、2023年11月15日~17日に立命館大学・朱雀キャンパスで開催される半導体実装技術に関する国際学会「IEE CPMT Symposium Japan (ICSJ)2023」において、プラチナスポンサーである当社ブースにて発表され、二酸化ゲルマニウム薄膜の大面積化の可能性を示す大きな成果となりました。
今後は、GeO2薄膜の電気特性評価や膜中に存在する欠陥評価等を行い、高品質なGeO2エピ製膜技術の開発を進めてまいります。
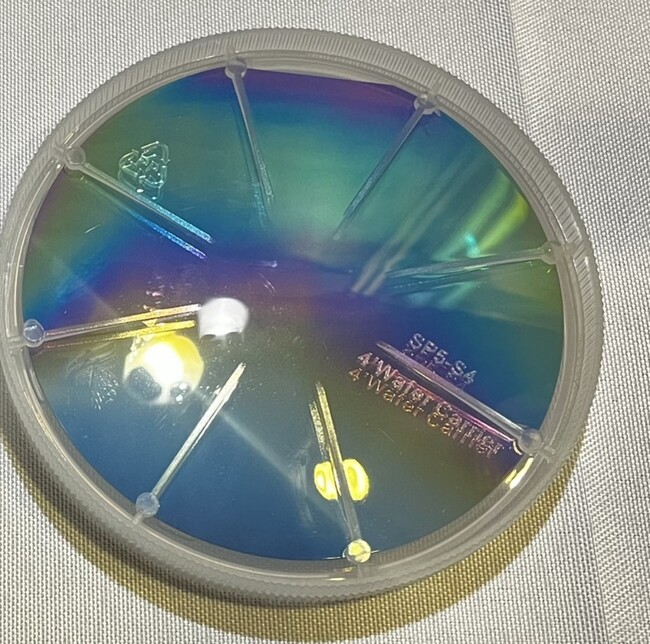
写真の説明:4インチウエハ上に成長した二酸化ゲルマニウムの写真。
https://www.patentix.co.jp/【世界初】phantom-svdファントム局所的気相成長法で4イ/
本件に関するお問い合わせ先
Patentix株式会社
広報担当:清水
TEL. 0775-99-1558 Email. y.shimizu@patentix.co.jp
立命館大学広報課 担当:名和
TEL. 075-813-8300 Email. r-koho@st.ritsumei.ac.jp